リソグラフィ工程における光強度・実形状を高精度に解析する実用的なシミュレータです。

特徴
光学系を忠実に再現
光学系における照明方法や、収差、デフォーカス等の効果を取り入れることで、完全な像形成をシミュレートできます。
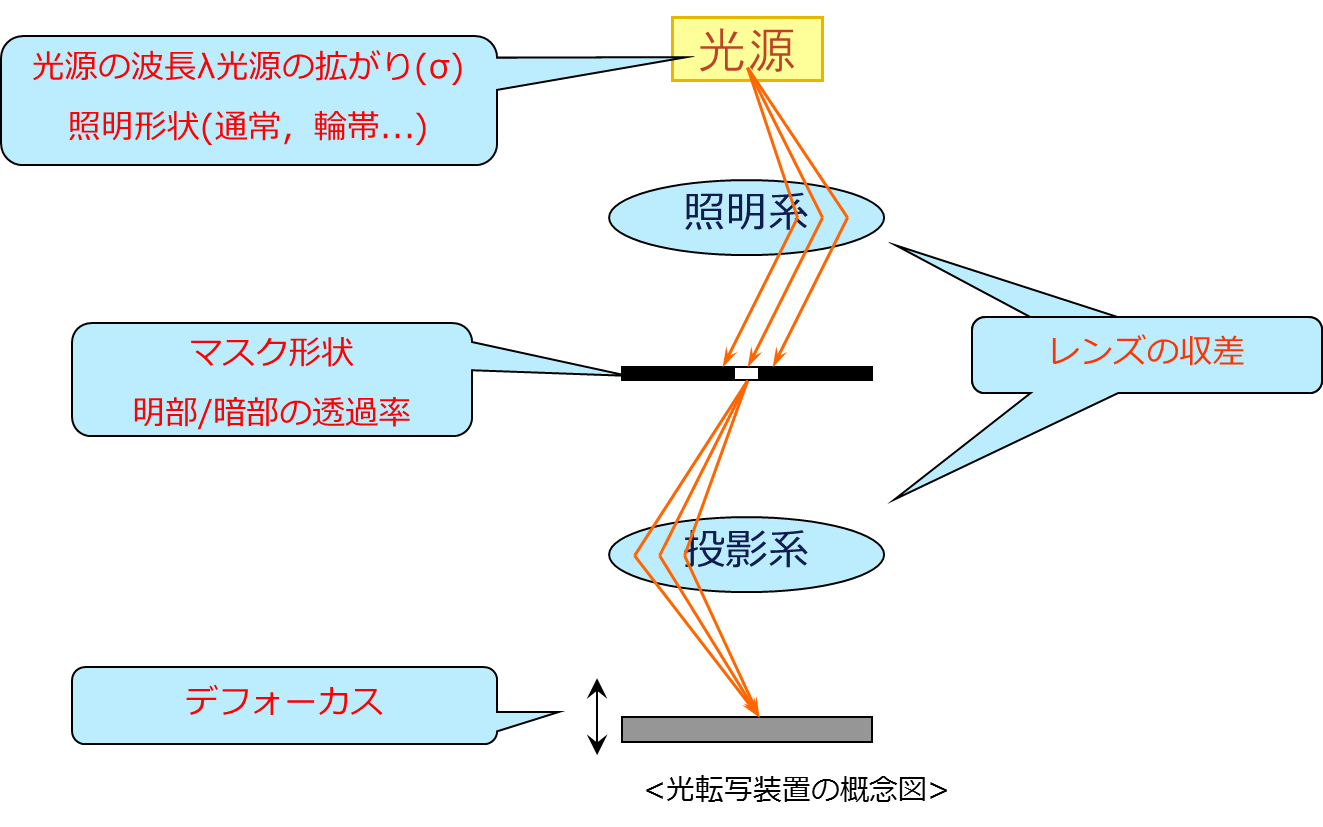
マスクデータから現像形状まで一貫した高精度計算
マスクデータと詳細な光学系パラメータに基づく「光強度計算」、レジストや基板の物性を考慮した「露光シミュレーション」が一貫して行えます。この際、Hopkinsの理論による相互透過係数(TCC)および光強度、フォトレジストの拡散距離を考慮するため、高精度に計算できます。
また、現像後の形状も計算することが可能です。計算した形状は、プロセスシミュレータParadiseWorld-2に取り込むことができます。
主な機能
- 収差
系におけるザイデル収差を考慮したシミュレーションが行えます。 - 位相シフト法
マスクに対して透過率を複素数で与えることができます。これにより、位相シフタを自由に配置できます。 - 照明方法
通常の円形照明の他に、輪帯照明や4点照明、4点十字照明を用いることができます。 - 瞳フィルタ
光学系の瞳には瞳フィルタを配置することができ、その透過率を複素数で与えることが可能です。 - 露光シミュレーション
Dillモデルによる露光シミュレーションを行うことで、レジスト濃度を計算できます。
シミュレーションでは、レジスト膜厚、レジストおよび基板の複素屈折率を設定できます。
また、Berningのアルゴリズムにより、レジスト内の定在波が考慮できます。 - 現像シミュレーション
露光シミュレーション結果に基づいて、現像後の形状が計算できます。
計算した形状はプロセスシミュレータParadiseWorld-2に取り込むことができます.
解析事例
光リソグラフィ工程の一貫した計算
本ツールを用いると、マスク形状から,最終的な現像形状を得ることができます。マスク中の光の伝搬,および基板での光の反射も解析しますので,マスク中に発生する定在波,ひいては,現像後にマスク側面に生じるラフネスも計算できます.
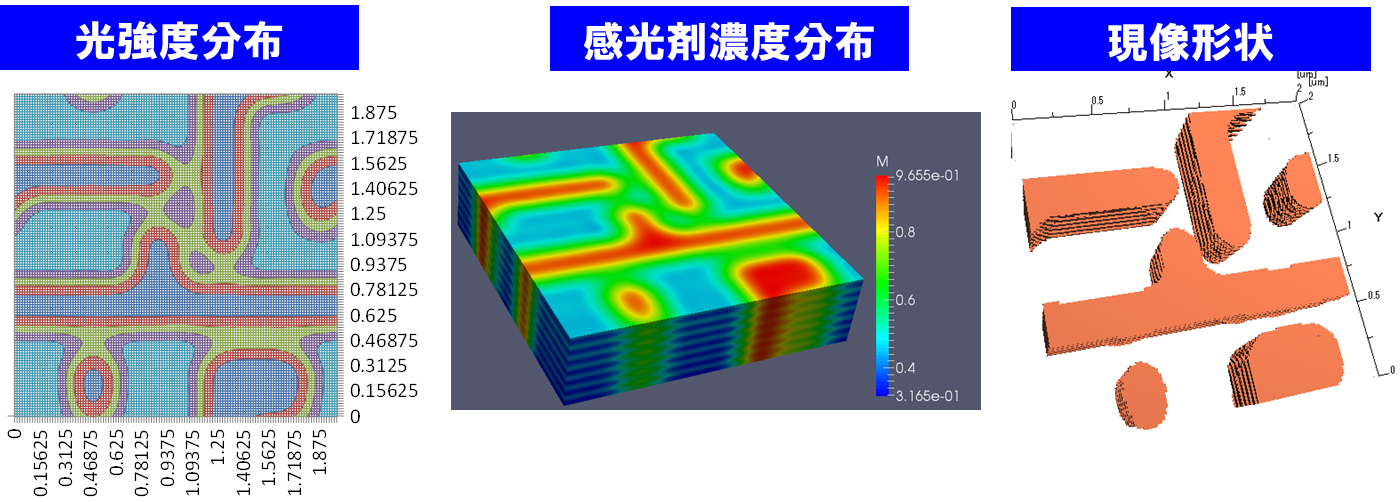
近接効果補正(OPC)
本ツールを用いると、近接効果補正が検討できます。補正前では、矩形マスクの角が丸くなっていたり、開口幅が小さな領域でマスクの長さが短くなったりしています。矩形マスクの角に補正図形を入れることで、マスクの丸まり具合や潰れ具合が軽減されています。
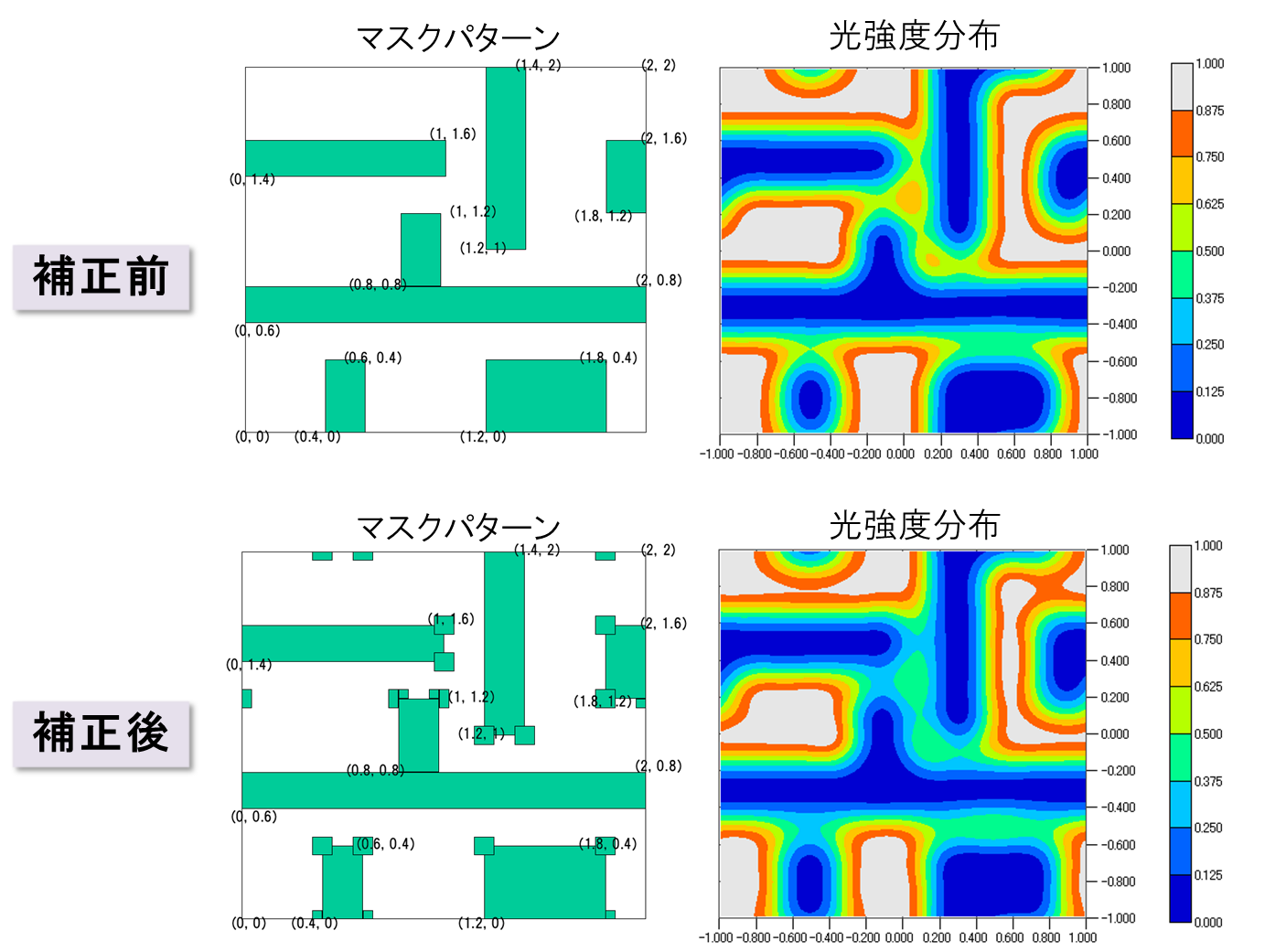
現像形状の NA 依存性
Line&Spaceパタンに対して,露光装置のレンズの性能指標である開口数 NA を変えて,現像後の形状を計算しました。NA が大きいほど解像度が高いため,レジストの側壁のテーパ角が小さな現像形状が得られます。
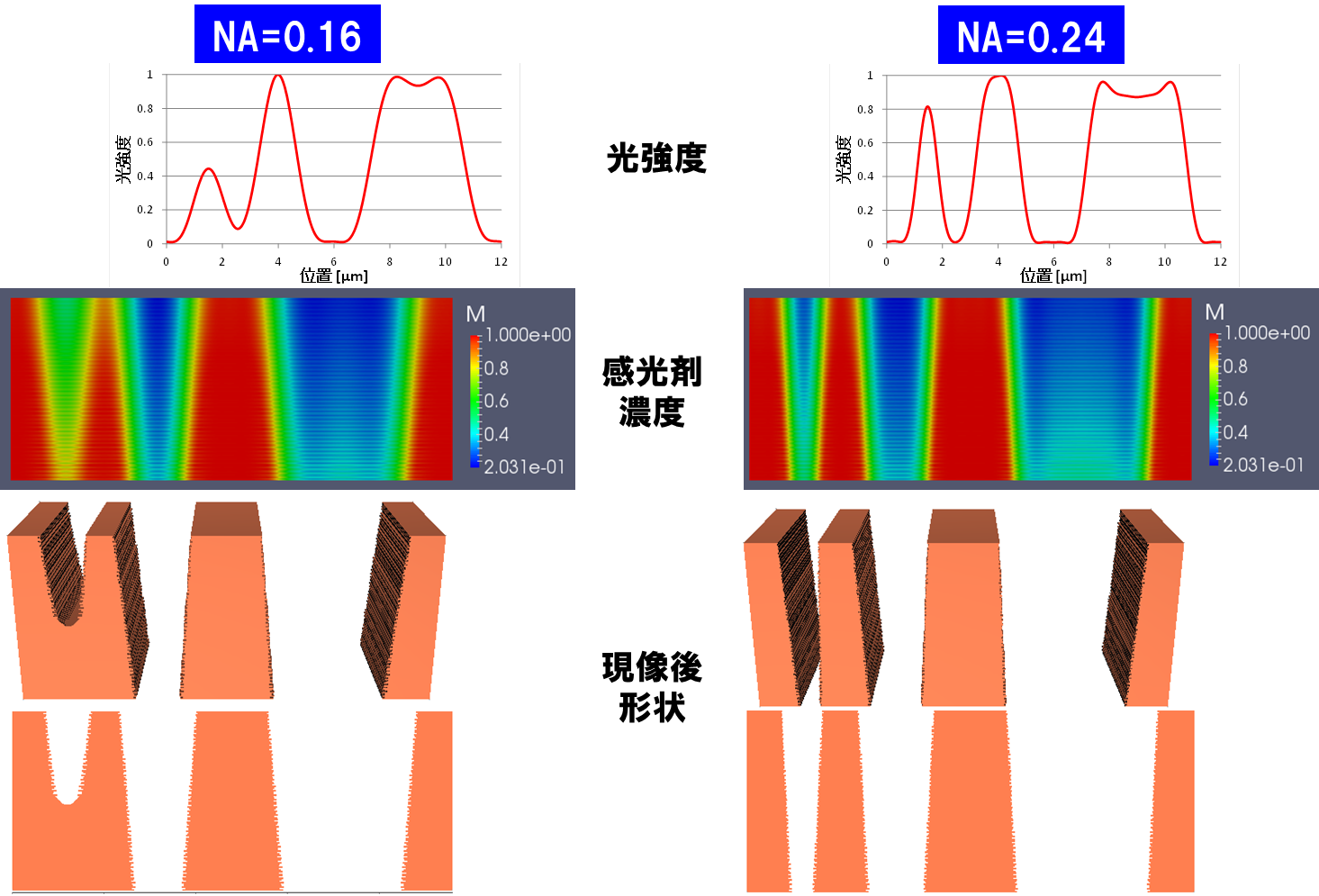
現像形状の開口幅依存性
プロセスシミュレータParadiseWorld-2と連携させて、近接場露光後の現像過程を計算しました。マスク開口幅が小さくなるほど回折効果が大きくなるため、現像形状にも違いが出てきます。

開口幅4μmの場合

開口幅10μmの場合
入力パラメータ
- 波長
- NA
- コヒーレンス因子
- マスクパターン
- マスク透過率
- デフォーカス
- 瞳フィルタの大きさ、透過率
- ザイデル収差の収差係数
- 各種収差パラメータ
- Dillパラメータ (A, B, C)
- レジストおよび基板の複素屈折率
出力データ
- ウェハ上における光強度分布
- ウェハ上におけるレジスト濃度分布
- ウェハ上における実形状データ
- お問い合わせ/資料請求
- 株式会社NTTデータ数理システム《EDA》担当
TEL. 03-3358-6681(10:00~16:00)
お問い合わせはこちら
製品サポートフォームは、当社が契約する 株式会社パイプドビッツの 情報管理システム「スパイラル」のページへリンクします。


